系統設計日趨複雜 電─熱協同分析勢在必行
不論是系統複雜度的提升或數據傳輸速率的加快,科技的持續進展同時加劇了熱效應問題。同時,IC封裝技術的日新月異,並朝異質整合發展,勢必得克服散熱設計的議題,而更密集的電晶體數量與更低的電壓,也使得IC內部更易於受到熱效應的影響...

對電子系統設計來說,熱效應對電氣效能的影響始終存在。眾所皆知,處理器速度和性能會受到熱的限制;舉例來說, 在行動和資料中心市場,功率一直是重要考量,特別是日益密集的電子元件會產生更多的熱量,對系統效能的影響更是不容忽視。在汽車市場,ADAS和車載資訊娛樂系統的導入,已使汽車內部的電子元件數量大幅增加,隨之帶來的熱效已是整體系統設計的關鍵因素。
另一方面,更高的數據率也同樣會產生熱量。乙太網路朝400G、800G邁進,PCIe藍圖也預測會到達64GT/s,5G的數據率更將達10Gb/s。正當業界摩拳擦掌準備迎接5G商機時,試想,相較於4G的100Mbps速度,5G的速度比現有4G技術快了100倍,隨之而來的熱─電交互作用與設計挑戰也將更為嚴峻。
顯然,不論是系統複雜度的提升或數據傳輸速率的加快,科技的持續進展也同時加劇了熱效應問題。與此同時,IC封裝技術的日新月異,並朝異質整合發展,勢必得克服散熱設計的議題,而在IC內部,更密集的電晶體數量與更低的電壓,也會使其更易於受到熱效應的影響。
「多重物理」(Multi-physics)問題
然而,電子系統的熱分析,並不是單純地把電氣與熱效應結合在一起就好。IC產生的熱,通常取決於切換頻率及運作條件,而熱是如何散逸/傳送到系統之外,則是與環境條件有關,這兩個問題必須一起解決。
而且,在晶片或電路板上,功率和溫度分佈不會維持不變,局部區域會產生熱點。因此,我們不能把整顆晶片視為同樣的溫度,我們必須知道不同位置的不同溫度,所以,位置已成為一個變數。同時,晶片和電路板之間的介面也日益模糊。我們必須把封裝和電路板視為晶片的延伸;訊號從電路板的走線通過封裝,然後到晶片。過去,我們認為這是三種不同的佈線,但現在,我們須將其視為同一條的長佈線。這些都意味著,我們須必在IC/封裝/電路板層級驗證功率與溫度的特性。
系統的熱散逸同時涉及熱傳導與熱對流。IC/封裝/電路板/機殼間的熱傳遞,主要是傳導問題,利用有限元素分析(FEA)是最好的處理方法。但是,機殼/環境(空氣或液體)之間的介面,則是計算流體力學(CFD)問題。所以,不僅電、熱兩個領域的物理學需一起分析,而且還需要同時採用FEA和CFD方式。此外,在整個電子組件上的熱流動與溫度梯度是由晶片的功率散逸所造成的。但是,功率又是溫度的函數,所以,它們彼此之間是交互影響的。這也是電─熱必須同時解決的原因。
傳統分析方式的瓶頸
受限於速度、容量以及運算資源,用傳統方式來解決FEA問題無法因應現今先進電子系統的高複雜度。另一方面,電─熱協同分析之間的複雜介面,需要進行更細部的分析。例如,3D-IC的簡單模型並不能提供系統級分析所需的精準度。因此,仍須採用FEA來分析,但必須突破上述的各種限制。為因應這些問題,業界需要可解決所有以上需求的完整方案,並能把晶片與電路板設計環境輕鬆地整合在一起。
Cadence最新推出的Celsius,便是因應此需求所開發的全新熱分析引擎。它能與Voltus在IC層級、以及Allegro在封裝與電路板層級共同運作。同時,它也能與Virtuoso協作,進行自訂佈局的最佳化,並與Innovus整合在一起。
這是電─熱協同分析的全新方法論,也是業界第一套能夠產生3D熱圖示的電─熱分析解決方案。Celsius利用創新的多重物理技術來克服這些設計挑戰。透過結合分析固體結構用的FEA以及流體用的CFD,Celsius能以單一工具,實現完備的系統分析。
此工具的另一項重要特性是,具備運算擴充性,支援分散式運算與適應性網格(adaptive meshing),以加速運算時間。
舉例來說,結合利用Celsius和Voltus,工程團隊可同時進行電─熱分析,並能以更準確的系統級熱模擬方式來模擬電與熱的流動。Celsius還能無縫地與Cadence的IC、封裝和PCB建置環境整合,使設計流程更快、更簡單。
此外,Celsius能根據電─熱的真實流動,支援先進3D結構中的靜態(穩態)和動態(暫態)電─熱協同模擬,以提供真實世界的系統行為的可視性。
為了真正實現系統及分析,而不是把系統分割為好幾塊進行分析,Celsius發揮了Cadence的計算軟體強項,能把大量的解算器擴充到雲端或自行部署的資料中心,不但運算容量不受限制,而且速度快了十倍。
總結
Celsius可支援大型系統的分析,這是過去傳統工具無法做到的。以下圖所示的實際案例為例,這是一個包含四片電路板,並以排線和連接器結合在一起的電子系統,包含高達1億個有限元素。若利用Celsius在40顆CPU上分析,速度比現有解算器快2.4倍。若進一步擴充至320顆CPU,分析速度可縮短10倍。

而在封裝內的晶片,亦可對其溫度分佈進行完整的分析。以下的圖例在視覺呈現上,我們能清楚看出晶片的溫度較高(紅色),而大部分的接腳溫度較低(綠色),只有少部分是橘色,而底下的基板溫度最低,為藍色。
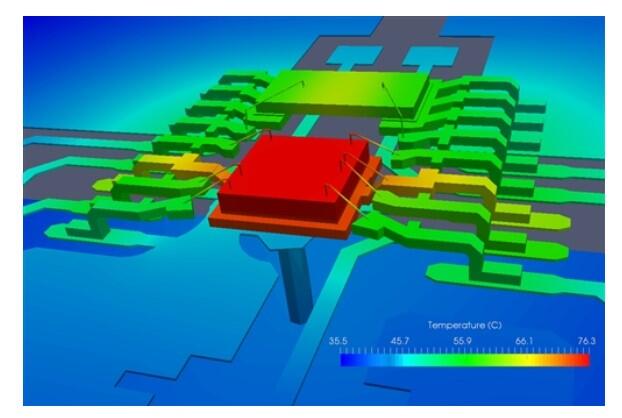
面對新興的5G、AIoT與各種智慧應用商機,電子系統的複雜度與異質整合趨勢將更為顯著。不論是哪一個應用市場,如何完整的分析熱效應,已成為開發新一代電子系統的重要考量,需要運用多重物理方式,結合FEA與CFD來實現電─熱協同分析。
而對積極尋求技術升級,開拓更寬廣市場的台灣科技產業來說,應盡早建立跨領域的分析能力,不僅有助於加速客戶產品開發的評估時程,更能降低失敗風險與研發成本。由於Celsius具備先進架構,突破了傳統分析工具的容量與速度限制,將能協助電子系統開發人員因應現今的散熱設計挑戰,厚植建立Turn-key設計流程的開發底蘊,以競逐更高階的應用商機。







訂閱EETimes Taiwan電子報
加入我們官方帳號LINE@,最新消息一手掌握!








